
| X. ZHOU |
© 1997
|
 |
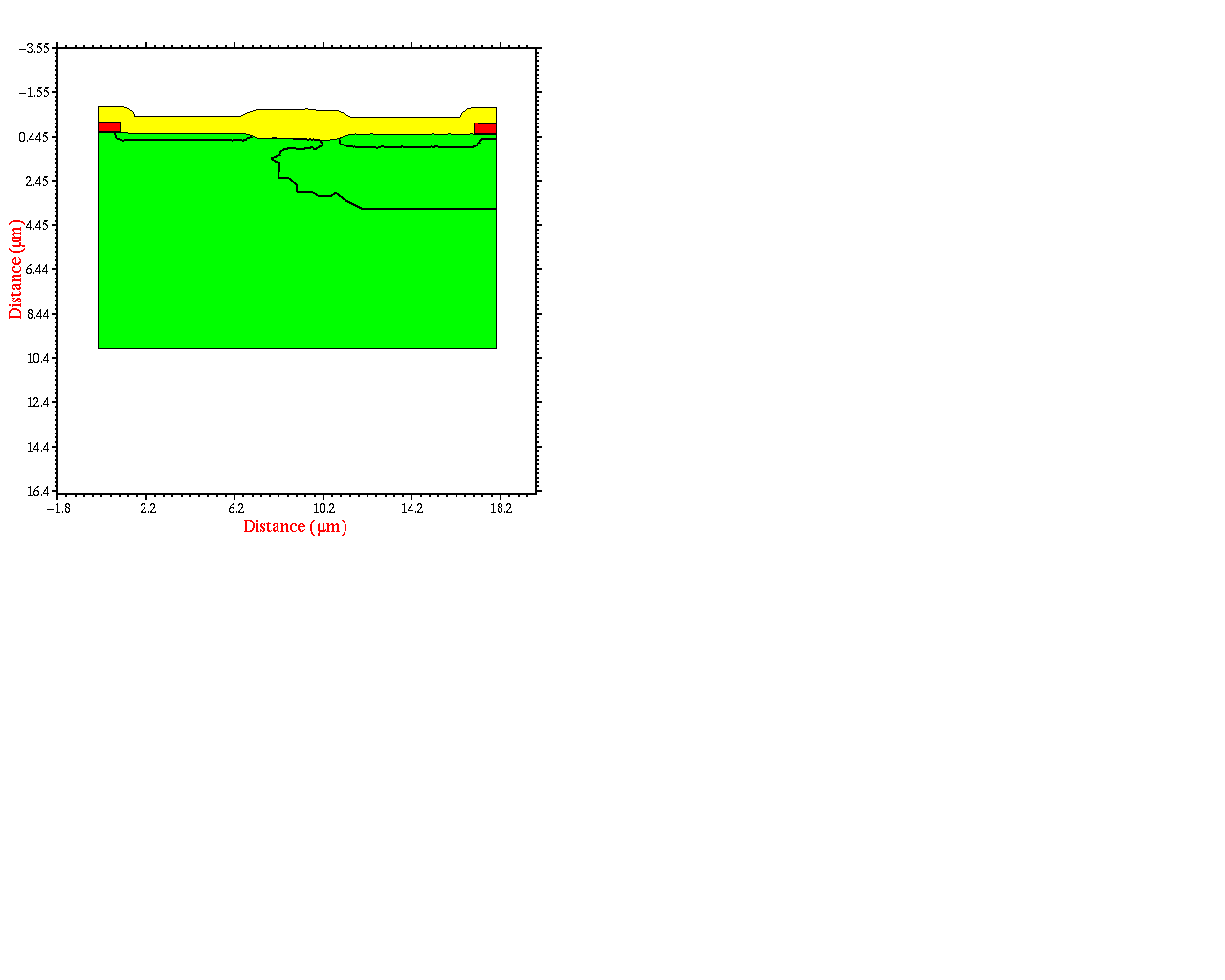
|
|
|
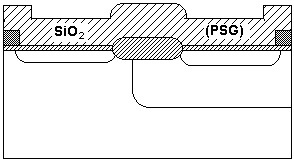 |
$step deposit_psg
deposition oxide thicknes=0.7 spaces=4 phos=1e20 concen $step densify_psg diffusion time=10 temp=750 t.final=950 inert diffusion time=5 temp=950 dryO2 diffusion time=20 temp=950 f.H2=3 f.O2=1.7 diffusion time=5 temp=950 dryO2 diffusion time=10 temp=950 t.final=750 inert $step extr_tox_psg extract oxide thicknes x=9 prefix="tox_psgf " suffix="(?) um" out.file=psg_dep:0_0.ext extract oxide thicknes x=4 prefix="tox_psgn " suffix="(?) um" out.file=psg_dep:0_0.ext extract oxide thicknes x=14 prefix="tox_psgp " suffix="(?) um" out.file=psg_dep:0_0.ext $step extr_xj select z=doping extract silicon d.extr x=4 value=0 prefix="xj_nch " suffix="(0.35) um" out.file=psg_dep:0_0.ext extract silicon d.extr x=14 value=0 prefix="xj_pch " suffix="(0.6) um" out.file=psg_dep:0_0.ext |